一.MEMS是什么?
MEMS是微机电系统(Micro-Electro-Mechanical System)的缩写,是微电路和微机械按功能要求在芯片上的集成,属于微电子技术与机械工程结合的一种工业技术。MEMS的内部通常包括微处理器和若干获取外界信息的微型传感器,可以实现对力、声、光、热、电、磁信号的感知和处理。
MEMS也被译作微电子机械系统,在日本称为微机械(Micromachines),在欧洲称为微系统(Microsystems)。另外还有操作范围在纳米级的纳机电系统(NEMS)与MEMS概念相似。

图1
MEMS作为各种消费级和工业级智能硬件(如自动驾驶)的基础技术,范围非常碎片化和多样化。图1表达现有MEMS技术的进展基本可以使一个机器人实现全方面的感知和人机交互。

图2
图2的表是对图1内容的整理,例举了多种MEMS装置或器件,它们被分为传感器(Sensors)和执行器(Actuators),同时与一些人体的组织、器官功能做了对应。
二.MEMS技术有什么应用价值?
下面介绍MEMS在个人消费电子、工业级应用,包括医疗设备领域的多个终端应用案例,更直观地展示MEMS作为基础技术的价值。

图3
先来看以智能手机为代表的个人消费电子领域。图3列出的MEMS器件或应用分别属于惯性(Inertial)、环境感测(Environmental)、光学(Optical)3个主要类别。智能手机及其它消费电子产品有用到惯性器件中的陀螺仪(Gyroscope)、加速度计(Accelerometer)和磁力计(Magnetometer);环境感测器中的麦克风、压力传感器;以及光学器件中属于图像传感器的功能。

图4
图4是一种扫描式微激光投影技术的原理图。其中右下角的二维MEMS扫描镜(2D MEMS Scanner Mirror)在投影区域按照特定轨迹,以光栅形式扫描由RGB激光管产生的单像素点激光束;扫描过程中同步调制3个激光管,控制单个像素点的颜色,形成画面。单像素点光学系统的设计保证了激光束的高度空间相关性,使投影画面总保持聚焦而清晰。

图5
图5出自全普光电公司,是将MEMS微激光投影与智能手机结合的效果,由激光亮度高且投影无需对焦,创造出随时随地大屏幕的新体验。未来以智能手机和可穿戴设备为主的消费电子产品,通过与MEMS微激光投影技术结合,在视觉交互功能上做出大突破,甚至实现全新的环境遥感体验,这可能成为新趋势。

图6
再来看工业级应用中的智能住宅和汽车。图6出自Sensor期刊中的文章,所谓智能住宅,要求同时具有高度舒适性、安全性、便利性、艺术性和可持续性。其中,对房屋内温度、湿度、气体、压力的实时监测要用到包括温度和湿度传感器、气体警报器、压力传感器在内的MEMS装置。另外,可以通过引入可信第三方(Trusted Third Party),降低对传感器的依赖,同时提高家电联网的安全性。

图7
前文提到的多种MEMS装置也是目前汽车的基本配置,包括惯性器件,如陀螺仪、加速度计;压力传感器,如机油压力传感器、安全气囊传感器;以及感测温度、湿度、气体的环境感测器。自动驾驶汽车则还需要增加用于实时监测路况的传感器设备,如图7。
图7出自咨询公司Yole。其中,长距雷达(Long-range radar)、短距雷达(Short-range radar),连同航位推测传感器(Dead reckoning sensors)和超声波(Ultrasound)传感器被归为非图像传感设备。属于图像传感设备范畴的可见光摄像头(Visible cameras),3D摄像头(3D cameras)、夜视摄像头(Night vision camera)应用了MEMS自动对焦(Autofocus)模组,使其对焦速度相比应用传统音圈电机模组(Voice Coil Motor Module)的设备提高了2-3倍,同时能耗更低、尺寸更小、寿命更长;激光雷达(LIDAR)也被归为图像传感设备。

图8
最后看医疗设备方面。图8出自Solid State Technology,表示MEMS装置和器件的尺寸从相当于头发(Hair)直径,到相当于红血细胞(Red Blood Cell)、大肠杆菌(E-coli)、HIV病毒,大小不等且差别很大。MEMS技术使医疗设备可以做到微型化,医疗检测、诊断、手术和治疗过程因而更加便捷、精准,甚至无痛。
MEMS图像传感器普遍应用于包括CT扫描(电子计算机断层扫描)、内窥镜在内的医学成像设备中,如Intuitive Surgical公司的达芬奇外科手术系统(da Vinci® Surgical System)使用的3D摄像头内窥镜,可以精准捕捉像素,让医生看到患者体腔内的高清立体影像,实现了在肺、肝脏和盆底这些狭小空间内的细致解剖,达到少出血、恢复快的微创手术效果。
MEMS惯性器件最主要用于心脏病治疗设备。传统的心脏起搏器存储正常心率,在异常情况下给心脏提供固定的电脉冲,其没有顾及所谓正常心率因人的不同特质及其所处环境而存在一定程度的差异。医疗科技公司美敦力(Medtronic),在心脏起搏器上增加了MEMS加速度计,使起搏器可以依据病人的生理活动实时调节电脉冲频率,从而实现个性化心脏治疗。
MEMS压力传感器可以检测包括血压(Blood Pressure)、眼内压(Intraocular Pressure)、颅内压(Intracranial Pressure)、子宫内压(Intrauterine Pressure)在内的人体器官压力水平。

图9
青光眼(Glaucoma)是眼内压间断或持续升高的一种眼病。图7是瑞士Sensimed AG公司采用意法半导体(STMicroelectronics)集团的MEMS眼内压传感器开发的隐形眼镜产品Triggerfish®,可以24小时连续记录眼尺寸变化,辅助监测病情。这是MEMS压力传感器的一个应用案例。
三.MEMS代表公司与产业链

图10
图10的表总结了部分具有代表性的MEMS装置或器件制造商及其国家和主要业务。晶圆厂是MEMS以至所有电子工业的基础,其投资建设动辄数百亿元。表中的前9家(从意法半导体到索尼)都是都是自有晶圆厂的整合元件制造商;国内实力雄厚的企业目前大多以晶圆代工为主要业务,如表中最后5家(从中芯国际到联华电子)。
从一级市场投资的角度来看,更加值得关注的可能是主要MEMS业务与终端应用紧密联系的公司,因为终端市场更容易细分,存在更多为创新准备的个性化需求和使用场景。例如,为iPhone 7和7 Plus提供MEMS麦克风的楼氏和歌尔声学,随着麦克风在消费电子产品中越来越成为普遍配置而获得了长足的发展。

图11
图11出自System Plus Consulting,显示两台iPhone 7 Plus中的共4个前置底部麦克风,有3个来自楼氏公司,1个来自歌尔声学;还有1个前置顶部麦克风来自意法半导体,1个后置顶部麦克风也由楼氏提供。这些MEMS麦克风都是苹果专用封装尺寸,又有不同的内部结构(如衬底金属层数、嵌入电容),用以实现高清语音录音。

图12
图12以MEMS芯片的生产制造过程为主线做梳理,将MEMS相关产业链分为4部分:晶圆厂(Fab)、芯片设计(Design)、封装及测试(Packaging & Testing),以及终端应用(Application);同时例举了相应的代表企业。
制造MEMS芯片的过程基本分为3步:芯片设计及试生产,规模化晶圆制造,封装测试。芯片试生产也称为流片(Tape Out),成功流片后就可以在晶圆厂启动晶圆制造(Wafer Fabrication);晶圆即单晶硅圆片,是生产集成电路(Integrated Circuit)的载体,晶圆制造的过程主要是复杂的集成电路工艺;进一步是将做完电路集成的整片晶圆切割为很多个小块晶片(Dies),行业中称为划片(Dicing),再经过封装和测试,最后应用到终端产品中。
四.关注MEMS封装技术的创新空间
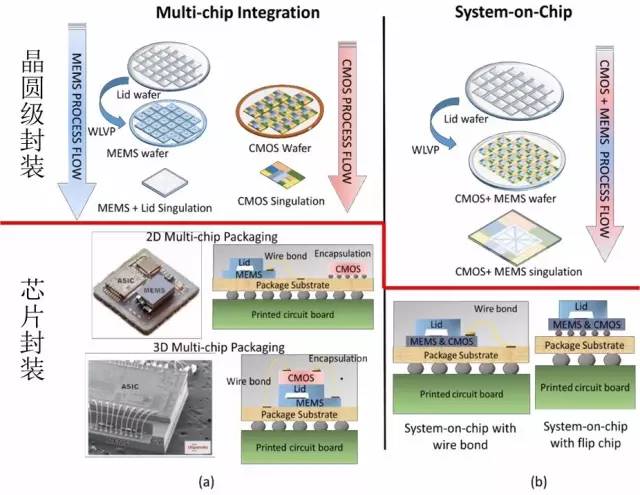
图13
封装是降低半导体集成电路尺寸、重量、能耗和成本的关键技术,包括晶圆级封装和芯片封装。图13出自Sensors期刊,描述了2种晶圆级真空封装(Wafer-Level Vacuum Packaging)技术和4种芯片封装技术。
图13左上方表示将MEMS和CMOS分别封装在不同晶圆上,其中,CMOS是互补式金属氧化物半导体(Complementary Metal-Oxide-Semiconductor)的缩写,是一种是制造大规模集成电路芯片的技术,也指用这种技术制造出来的芯片;左下方表示MEMS和CMOS可以通过2D或3D多芯片封装(Multi-chip Packaging)技术完成芯片封装;右上方表示在晶圆级真空封装过程中,将MEMS和CMOS集成到同一片晶圆上;右下方表示集合了MEMS和CMOS功能的芯片可以通过丝焊法(Wire Bond)或覆晶技术(Flip Chip)完成芯片封装,称为片上系统(System-on-Chip)封装。
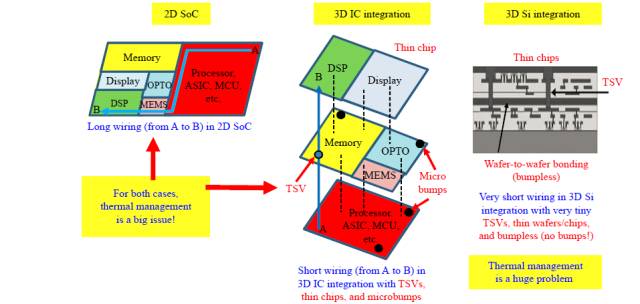
图14
图14出自国际微电子学(Microelectronics International)期刊,例举了2种代表性封装技术,分别是最左边的2D片上系统(2D SoC)封装和中间的3D集成电路堆叠(3D IC integration)封装,并且认为后者优于前者;最右边的3D硅集成(3D Si integration)是3D集成电路堆叠封装中的一例。
如图中底部的蓝色和红色英文所写,通过将集成电路堆叠起来,可以缩短数字信号处理器(Digital Signal Processor,图中为DSP)与处理器(Processor. ASIC, MCU, etc.)之间的连线,即缩短图中从A点到B点的连线,其中需要用到硅穿孔(Through-SiliconVia,图中为TSV)、薄芯片(Thin Chips)和微凸起(Microbumps)。其中,ASIC是指特殊应用集成电路(Application Specific Integrated Circuit),MCU是指微程序控制器(Microprogrammed Control Unit)。
封装可能在目前是整个MEMS芯片制造过程中最具挑战性和创新空间的部分。例如,对于2D片上系统封装和3D集成电路堆叠封装的芯片,热耗散都是大问题;堆叠集成电路的过程中,体积不同、处理速度不同的芯片按照什么标准来组合;以及检测成品性能的标准和方法匮乏。这些都是值得创业者和投资人关注的机会。